Одной из задач почвоведческой экспертизы является установление компонентного состава образцов почв. Под компонентным составом пони-мается минералогический состав, а также информация о техногенных загрязнениях, о частицах растительного и животного происхождения и т.д. Для определения компонентного состава можно при-менять сканирующий электронный микроскоп (СЭМ), основное преимущество которого в данном случае заключается в том, что СЭМ позволяет получать одновременно и изображение микроструктуры, и локальный1 состав каждого компонента.
Наиболее удобным образцом для такого рода экспертиз является полированная эпоксидная шайба с запрессованными в нее частицами почвы (рис. 2а). В одной шайбе могут содержаться десятки и сотни тысяч частиц, каждая из которых, как правило, состоит из нескольких компонентов (рис. 2б). Для полноценного анализа требуется идентифицировать все компоненты во всех частицах и сохранить информацию об их морфологии. Очевидно, это очень трудоемкая задача, если решать ее «вручную», и результат будет чреват ошибками, вызванными субъективным фактором. Для автоматизации подобного рода исследований компания TESCAN Orsay Holding разработала систему TESCAN TIMA.
В данной работе изучались 2 образца почв, которые были собраны в Норильске рядом с Никелевым заводом (НЗ) и с Малой обогатительной фабрикой (МОФ). Были подготовлены аншлифы диаметром 25 мм, которые исследовались на сканирующем электронном микроскопе TESCAN TIMA 3 LMH с вольфрамовым катодом (рис. 1).

Рис. 1: В данной работе использовался сканирующий электронный микроскоп TESCAN TIMA 3 LMH
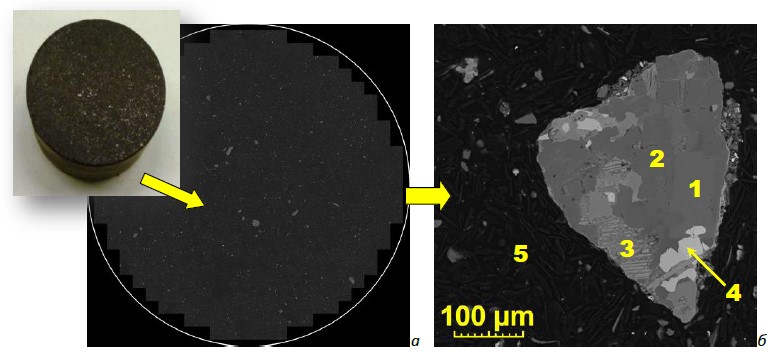
Рис. 2 – а) панорамное электронное изображение аншлифа диаметром 25 мм, полученное сшивкой 440 шт. по-лей размером 1 × 1 мм2 каждое; б) типичная частица почвы, образованная зернами анортита (1), кварца (2), хлорита (3), магнетита (4) и проч. (5 — эпоксидный наполнитель)
1 В силу физических особенностей метода локальность спектрального микроанализа составляет от ~ 0,5 мкм до ~ 4 мкм в зависимости от плотности анализируемого компонента и от выбранных настроек СЭМ, что на не-сколько порядков хуже, чем пространственное разрешение СЭМ.
В автоматическом режиме сканировалась вся площадь поверхности аншлифов. С каждого пик-селя каждого компонента каждой частицы соби-рались спектры с помощью 4-х энергодисперси-онных спектрометров (ЭДС). Именно на основе анализа спектров выполнялись идентификация и оконтуривание компонентов (рис. 3).
Образец почвы, собранной рядом с НЗ.
Время на сбор и анализ данных 40 минут*
| Тип | Компонент | % масс. |
| минеральн. | плагиоклазы, в том ч. | 20,72 |
| анортит | 17,49 | |
| альбит | 3,23 | |
| пироксены, в том ч.: | 9,91 | |
| энстатит | 0,49 | |
| кварц | 9,49 | |
| оксиды и гидроокс. Fe | 7,17 | |
| хлорит | 6,91 | |
| ортоклаз | 5,92 | |
| каолинит | 3,54 | |
| мусковит | 2,54 | |
| оливины, в том ч.: | 2,04 | |
| фаялит | 0,46 | |
| ильменит | 1,07 | |
| пирротин | 0,97 | |
| халькопирит | 0,37 | |
| гипс | 0,29 | |
| титаномагнетит | 0,23 | |
| техногенн. | оксисульфиды Cu-Ni | 14,09 |
| халькозин-борн.тв. р-р | 9,49 | |
| шлаки | 4,66 | |
| оксид Ni | 0,28 | |
| металл на основе Ni | 0,31 |
Известно, что в полупродуктах с Никелевого завода не должно быть металлической меди. Действительно, металл на основе Cu найден в почве рядом с МОФ, но такой составляющей нет в почве рядом с НЗ (см. таблицу ниже, в данной ра-боте анализировались только минералы и техно-генные загрязнения, а частицы растительного и животного происхождения не рассматривались).
Образец почвы, собранной рядом с МОФ.
Время на сбор и анализ данных 68 минут*
| Тип | Компонент | % масс. |
| минеральн. | плагиоклазы, в том ч. | 13,53 |
| анортит | 6,49 | |
| альбит | 2,90 | |
| пироксены, в том ч.: | 13,32 | |
| энстатит | 8,61 | |
| кварц | 13,19 | |
| хлорит | 3,42 | |
| оксиды и гидроокс. Fe | 3,18 | |
| ортоклаз | 2,34 | |
| оливины, в том ч.: | 1,85 | |
| фаялит | 0,27 | |
| каолинит | 1,37 | |
| мусковит | 0,99 | |
| пирротин | 0,46 | |
| кальцит | 0,34 | |
| гипс | 0,25 | |
| силикаты Ti, в том ч.: | 0,19 | |
| титанит | 0,11 | |
| ильменит | 0,14 | |
| силикаты Al | 0,12 | |
| халькопирит | 0,09 | |
| титаномагнетит | 0,02 | |
| техногенн. | шлаки | 25,37 |
| оксисульфиды Cu-Ni | 13,51 | |
| халькозин-борн.тв. р-р | 0,14 | |
| оксид Ni | 0,67 | |
| металл на основе Ni | 0,17 | |
| металл на основе Cu | 5,33 |
* — параметры сканирования:
размер пикселя 5 мкм, ускоряющее напряжение 25 кВ, ток зонда 16 нА, 4 ЭДС-спектрометра с активной площадью п/п кристалла каждого 30 мм2