Методы электронной микроскопии основаны на различных эффектах взаимодействия электронного пучка с образцом. Один из таких эффектов – генерация электрон-дырочных пар в полупроводнике – лежит в основе многих электрофизических методик исследования и контроля образцов. На схематическом рисунке показана энергетическая диаграмма обыкновенного p-n перехода.

Когда пучок электронов попадает в область p-n перехода (б), то электроны и дырки, возникающие под действием электронного пучка, расходятся в разные стороны за счет электрического поля, присутствующего в области перехода. Носители заряда, которые возникают в объеме полупроводника (а), где отсутствует электрическое поле, с большой вероятностью рекомбинируют друг с другом.
Для проведения измерений и получения изображений электронные микроскопы TESCAN могут оснащаться детектором EBIC – детектором тока, индуцированного электронным пучком.
Если подключить устройство, содержащее p-n переход к детектору EBIC, то на изображении станут видны области, содержащие p-n переход, яркость которых будет зависеть от параметров перехода.
На изображении внизу страницы показан участок интегральной схемы с подключенными контактами. На изображении во вторичных электронах (SE) хорошо видна топография поверхности микросхемы, но такое изображение не несет информацию о внутренней структуре образца.
Изображение с детектора EBIC, получаемое одновременно с сигналом вторичных электронов, показывает области, содержащие защитные диоды, белый и черный цвета соответствуют разной полярности подключения диодов.
В данном случае детектор EBIC подключался между корпусом и выводами микросхемы. Если микроскоп дополнительно оснастить манипуляторами, то пользователю предоставляется возможность подключать детектор к произвольным точкам микросхемы, для проведения поэлементной проверки всех частей интегральной микросхемы без извлечения образца из камеры микроскопа.
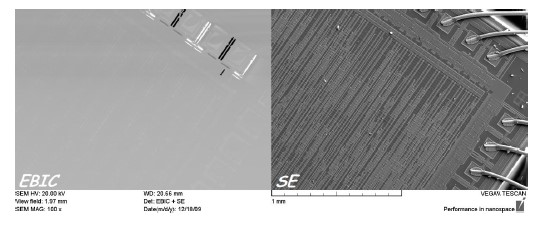
Детектор EBIC, предлагаемый TESCAN, имеет возможность не только измерять наведенный ток, но и к исследуемому образцу прикладывать напряжение от -5 до +5 В. Прикладывая различные по величине обратные напряжения смещения, с помощью детектора EBIC можно визуализировать области наибольшего падения напряжения. Такие измерения могут использоваться для контроля напряжения пробоя и поиска дефектов в интегральных схемах. Одно из применений детектора EBIC – контроль изготовления фотоприемников и фотоэлектрических преобразователей.
Пучок электронов часто приводит к эффектам, схожим с теми, которые вызывает падающий свет. Повышая ускоряющее напряжение, можно увеличивать глубину проникновения пучка электронов и изучать слои материала на глубине вплоть до нескольких мкм.
На изображении показан участок элемента солнечной батареи. Ускоряющее напряжение микроскопа выбрано так, чтобы продемонстрировать неравномерность защитного покрытия элемента. Такой метод контроля качества покрытия является неразрушающим и в то же время позволяет предотвратить преждевременный выход элементов из строя.
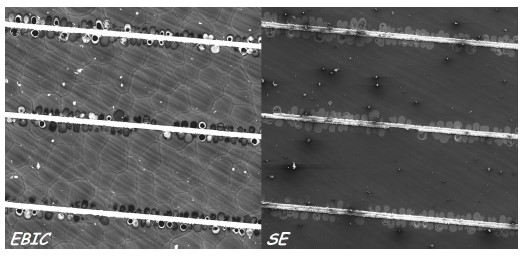
| Сканирующий электронный микроскоп TESCAN Vega 3 LMH | Разрешение при 30кВ | 3 нм |
| Детекторы | SE, BSE | |
| Ускоряющее напряжение | от 200 В до 30 кВ | |
| Ток пучка | От 1 пА до 2 мкА | |
| Тип столика | Эвцентрический, моторизованный по 5 осям | |
| Наклон столика | ± 70⁰ | |
| Детектор EBIC | Диапазоны измеряемых токов | ±200 нА; ±2 мкА; ±20 мкА |
| Напряжение смещения | От -5В до +5В | |
| Управление | Интегрировано в ПО микроскопа |

