Основными преимуществами сталей аустенитного класса являются их высокие служебные характеристики (прочность, пластичность, коррозионная стойкость в большинстве рабочих сред) и хорошая технологичность. Поэтому аустенитные коррозионностойкие стали нашли широкое применение в качестве конструкционного материала в различных отраслях машиностроения.
Свойства стали определяются ее внутренней микроструктурой и дефектами кристаллической решетки. В настоящее время для металлографического исследования структуры широко применяются методы электронной микроскопии наряду с более традиционными методами анализа с помощью оптического микроскопа. Использование просвечивающего электронного микроскопа (TEM – transmission electron microscope) позволяет определять плотность дислокаций, дислокационных петель, анализировать выделения вторичных фаз и визуализировать поры и другие дефекты. Такие исследования проводятся как для определения механических свойств новых сплавов, так и для оценки радиационной стойкости различных материалов.
Большинство современных просвечивающих микроскопов имеют возможность работать в режиме STEM (scanning TEM), в котором пучок электронов фокусируется в точку, которая перемещается по поверхности образца как точно так же, как это происходит в сканирующем электронном микроскопе. Высокое пространственное разрешение на просвечивающих сканирующих электронных микроскопах достигается за счет подготовки сверхтонких срезов материала и хорошо сфокусированного пучка электронов. Стандартный образец для просвечивающей микроскопии представляет собой диск исследуемого материала диаметром 3.05 мм, утоненного в середине химическим или ионным путём. В некоторых случаях для TEM применяются металлические сетки с плёнкой- подложкой на которых размещаются исследуемые материалы.

Для работы с такими образцами компания TESCAN предлагает детектор прошедших электронов, реализующий режим сканирующей просвечивающей электронной микроскопии на микроскопах серий VEGA, MIRA, LYRA и VELA.
Детектор прошедших электронов устанавливается на столик микроскопа и регистрирует прошедшие через образец электроны. Изображение в светлом поле формируется датчиком, расположенным непосредственно под образцом, а изображение в темном поле складывается из сигналов двух датчиков, расположенных в стороне от оптической оси. Изображение в светлом поле эквивалентно изображению, получаемому в режиме светлого поля STEM, а изображение в темном поле может давать ориентационный контраст.

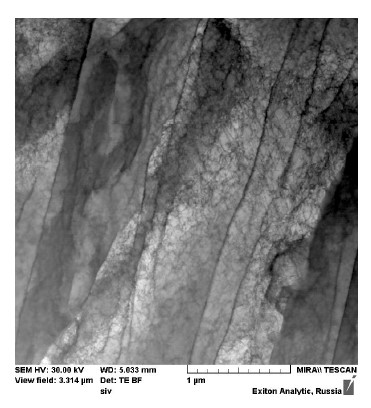
На изображении выше показан участок образца аустенитной нержавеющей стали после ее деформации, полученный с помощью детектора прошедших электронов в режиме светлого поля, установленного на микроскоп Mira LMU. Темные линии вдоль картинки показывают границы отдельных зерен, а сетка мелких линий показывает дислокации, возникающие в образце в результате его деформации. Кроме этого детектор TE позволяет наблюдать и другие дефекты, такие как поры и выделения вторичных фаз. При выборе детектора TE как основного метода исследования структуры стали следует особое внимание уделять подготовке образцов.
В связи с тем, что ускоряющее напряжение сканирующего микроскопа ограничено 30 кВ, для получения изображений высокого разрешения требуется получать достаточно тонкие образцы стали, и в некоторых случаях это может приводить к дефектам пробоподготовки, как это произошло с образцом на картинке ниже. Детектор TE обладает высокой чувствительностью, достаточной для комфортной работы на микроскопах серии Vega при токах пучка несколько пА., с возможностью исследования объектов размерами от нескольких нанометров.

Рекомендуемая минимальная конфигурация и технические характеристики
| Сканирующий электронный микроскоп TESCAN Vega 3 SBH | Разрешение при 30кВ | 3 нм |
| Детекторы | SE, BSE | |
| Ускоряющее напряжение | от 200 В до 30 кВ | |
| Ток пучка | От 1 пА до 2 мкА | |
| Тип столика | моторизованный по 3 осям | |
| Детектор TE | Режим работы | Светлое поле (BF), темное поле (DF) |
| Достижимое разрешение | 3,5 нм (серия Vega) | |
| Управление | Интегрировано в ПО микроскопа |

